Félvezető lézeres emelőberendezések forradalmasítják a rúdvékonyítást
Részletes ábra
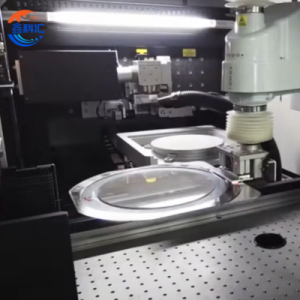
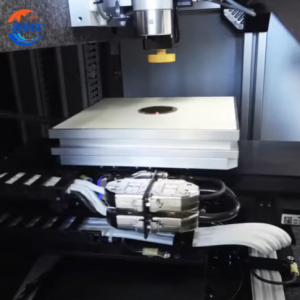
Félvezető lézeres emelőberendezések termékbemutatója
A félvezető lézeres emelőberendezés egy speciális ipari megoldás, amelyet a félvezető tuskók lézerindukált emelőtechnikával történő precíz és érintésmentes elvékonyítására terveztek. Ez a fejlett rendszer kulcsszerepet játszik a modern félvezető ostyagyártási folyamatokban, különösen a nagy teljesítményű teljesítményelektronika, LED-ek és RF eszközök ultravékony ostyáinak gyártásában. Azzal, hogy lehetővé teszi a vékony rétegek elválasztását a tömbös tuskóktól vagy donor szubsztrátumoktól, a félvezető lézeres emelőberendezés forradalmasítja a tuskavékonyítást a mechanikus fűrészelés, csiszolás és kémiai maratás lépéseinek kiküszöbölésével.
A félvezető tömbök, például a gallium-nitrid (GaN), a szilícium-karbid (SiC) és a zafír hagyományos vékonyítása gyakran munkaigényes, pazarló, és hajlamos a mikrorepedésekre vagy felületi sérülésekre. Ezzel szemben a félvezető lézeres emelőberendezések roncsolásmentes, precíz alternatívát kínálnak, amely minimalizálja az anyagveszteséget és a felületi feszültséget, miközben növeli a termelékenységet. Számos kristályos és összetett anyagot támogat, és zökkenőmentesen integrálható az elő- vagy középáramú félvezető gyártósorokba.
Konfigurálható lézerhullámhosszainak, adaptív fókuszrendszereinek és vákuumkompatibilis ostyatokkjainak köszönhetően ez a berendezés különösen alkalmas bugák szeletelésére, lamellák létrehozására és ultravékony filmek leválasztására függőleges eszközszerkezetek vagy heteroepitaxiális rétegátvitel esetén.

A félvezető lézeres emelőberendezés paraméterei
| Hullámhossz | IR/SHG/THG/FHG |
|---|---|
| Impulzus szélesség | Nanoszekundum, pikoszekundum, femtoszekundum |
| Optikai rendszer | Fix optikai rendszer vagy galvano-optikai rendszer |
| XY szakasz | 500 mm × 500 mm |
| Feldolgozási tartomány | 160 mm |
| Mozgási sebesség | Max. 1000 mm/s |
| Ismételhetőség | ±1 μm vagy kevesebb |
| Abszolút pozíciópontosság: | ±5 μm vagy kevesebb |
| Ostya mérete | 2–6 hüvelyk vagy egyedi méretben |
| Ellenőrzés | Windows 10, 11 és PLC |
| Tápfeszültség | AC 200 V ±20 V, egyfázisú, 50/60 kHz |
| Külső méretek | 2400 mm (Sz) × 1700 mm (M) × 2000 mm (Ma) |
| Súly | 1000 kg |
A félvezető lézeres emelőberendezések működési elve
A félvezető lézeres kiemelő berendezés alapvető mechanizmusa a donoröntvény és az epitaxiális vagy célréteg közötti határfelületen történő szelektív fototermikus lebontáson vagy abláción alapul. Egy nagy energiájú UV-lézert (jellemzően KrF 248 nm-en vagy szilárdtest UV-lézerek körülbelül 355 nm-en) egy átlátszó vagy félig átlátszó donoranyagon keresztül fókuszálnak, ahol az energia szelektíven elnyelődik egy előre meghatározott mélységben.
Ez a lokalizált energiaelnyelés egy nagynyomású gázfázist vagy hőtágulási réteget hoz létre a határfelületen, amely megindítja a felső ostya- vagy eszközréteg tiszta delaminációját a tuskó alapjáról. A folyamatot finomhangolják olyan paraméterek beállításával, mint az impulzusszélesség, a lézerfluencia, a szkennelési sebesség és a z-tengely fókusztávolsága. Az eredmény egy ultravékony szelet – gyakran 10-50 µm tartományban –, amely tisztán elválik az alaptuskától mechanikai kopás nélkül.
Ez a lézeres leválasztási módszer a bugavékonyításhoz elkerüli a gyémántdrótos fűrészeléssel vagy mechanikus leppeléssel járó vágási veszteséget és felületi károsodást. Emellett megőrzi a kristály integritását és csökkenti a későbbi polírozási igényeket, így a félvezető lézeres leválasztási berendezések forradalmi eszközzé válnak a következő generációs wafergyártásban.
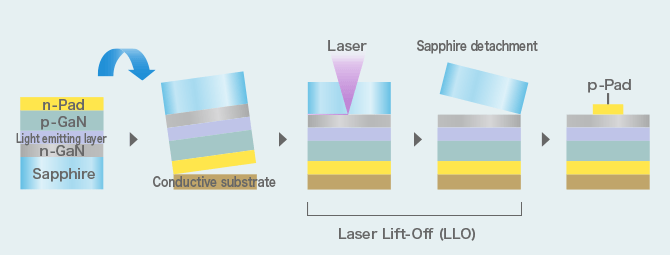
Félvezető lézeres emelőberendezések alkalmazásai
A félvezető lézeres emelőberendezések széles körben alkalmazhatók a bugák vékonyításában számos fejlett anyag és eszköztípus esetében, beleértve:
-
GaN és GaAs öntvényhígítás erőeszközökhöz
Lehetővé teszi vékony ostyák létrehozását nagy hatékonyságú, alacsony ellenállású teljesítménytranzisztorokhoz és diódákhoz.
-
SiC szubsztrát visszanyerése és lamellák szétválasztása
Lehetővé teszi a lapka méretű felemelést a tömör SiC-hordozókról függőleges eszközszerkezetek és lapka-újrafelhasználás céljából.
-
LED ostya szeletelés
Megkönnyíti a GaN rétegek leemelését vastag zafíröntvényekről, így ultravékony LED-szubsztrátumokat hoz létre.
-
RF és mikrohullámú eszközök gyártása
Támogatja az 5G és radarrendszerekben szükséges ultravékony, nagy elektronmobilitású tranzisztor (HEMT) struktúrákat.
-
Epitaxiális rétegátvitel
Precízen leválasztja az epitaxiális rétegeket a kristályos öntvényekről újrafelhasználás vagy heterostruktúrákba való integrálás céljából.
-
Vékonyrétegű napelemek és fotovoltaikus rendszerek
Vékony abszorber rétegek elválasztására használják rugalmas vagy nagy hatékonyságú napelemekhez.
Ezen területek mindegyikén a félvezető lézeres emelőberendezések páratlan kontrollt biztosítanak a vastagság egyenletessége, a felületi minőség és a rétegek integritása felett.
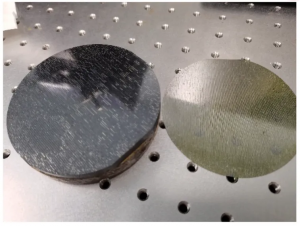
A lézeres tuskóhígítás előnyei
-
Nulla vágási vágási anyagveszteség
A hagyományos ostyaszeletelési módszerekkel összehasonlítva a lézeres eljárás közel 100%-os anyagkihasználást eredményez.
-
Minimális feszültség és vetemedés
Az érintkezésmentes leválasztás kiküszöböli a mechanikai rezgést, csökkentve a lapka meghajlását és a mikrorepedések kialakulását.
-
Felületminőség megőrzése
Sok esetben nincs szükség utólagos csiszolásra vagy polírozásra, mivel a lézeres leválasztás megőrzi a felső felület épségét.
-
Nagy áteresztőképességű és automatizálásra kész
Automatizált be- és kirakodással műszakonként több száz hordozó feldolgozására képes.
-
Több anyaghoz is adaptálható
Kompatibilis GaN, SiC, zafír, GaAs és az újonnan megjelenő III-V anyagokkal.
-
Környezetbarátabb
Csökkenti a zagyalapú hígítási folyamatokban jellemző súrolószerek és agresszív vegyszerek használatát.
-
Hordozó újrafelhasználása
A donoröntvények több kiemelési ciklusban újrahasznosíthatók, ami jelentősen csökkenti az anyagköltségeket.
Gyakran Ismételt Kérdések (GYIK) a Félvezető Lézeres Emelőberendezésekkel Kapcsolatban
-
1. kérdés: Milyen vastagságtartományt tud elérni a félvezető lézeres emelőberendezés ostyaszeletek esetén?
A1:A tipikus szeletvastagság 10 µm és 100 µm között mozog az anyagtól és a konfigurációtól függően.2. kérdés: Használható ez a berendezés átlátszatlan anyagokból, például SiC-ből készült tuskók vékonyítására?
A2:Igen. A lézer hullámhosszának hangolásával és a határfelület-tervezés optimalizálásával (pl. áldozati közbenső rétegek) akár részben átlátszatlan anyagok is feldolgozhatók.3. kérdés: Hogyan van beállítva a donor hordozó a lézeres felemelése előtt?
A3:A rendszer szubmikronos, látásalapú igazító modulokat használ, amelyek visszajelzést adnak a referenciajelekből és a felületi fényvisszaverődési vizsgálatokból.4. kérdés: Mi a várható ciklusidő egy lézeres kiemelési műveletnél?
A4:A lemez méretétől és vastagságától függően a ciklusok általában 2-10 percig tartanak.5. kérdés: A folyamathoz tisztatéri környezet szükséges?
A5:Bár nem kötelező, a tisztatéri integráció ajánlott az aljzat tisztaságának és az eszközhozam fenntartása érdekében a nagy pontosságú műveletek során.
Rólunk
Az XKH speciális optikai üvegek és új kristályanyagok high-tech fejlesztésére, gyártására és értékesítésére specializálódott. Termékeink az optikai elektronikát, a szórakoztató elektronikát és a katonai ipart szolgálják ki. Zafír optikai alkatrészeket, mobiltelefon-lencsevédőket, kerámiákat, LT-t, szilícium-karbid SIC-t, kvarcot és félvezető kristálylapokat kínálunk. Szakképzett szakértelmünkkel és élvonalbeli berendezéseinkkel kiválóan teljesítünk a nem szabványos termékfeldolgozásban, és célunk, hogy vezető optoelektronikai anyagokat gyártó high-tech vállalattá váljunk.










